半导体材料发展经历了3代。以第1代半导体材料硅(Si)为衬底制作的芯片,遍布生活中的电子电器、通讯设备,95%以上的半导体器件采用Si做衬底。第2代半导体材料以GaAs、磷化铟(InP)为代表,伴随着光纤通讯、移动互联的高速发展而出现和壮大,它适用于制作高性能微波、毫米波器件及发光器件。第3代半导体材料以GaN、 (SiC等)为代表,近年来引起广泛的研究。它的禁带宽度更大,热导率、击穿电场、电子饱和速率都更高,在固态光源、微波射频器件等领域有着极其大的应用前景。其中,第2代、第3代半导体功率器件对芯片的散热提出了很高要求,使热沉材料的发展得以与半导体材料的发展保持同步(见表1)。
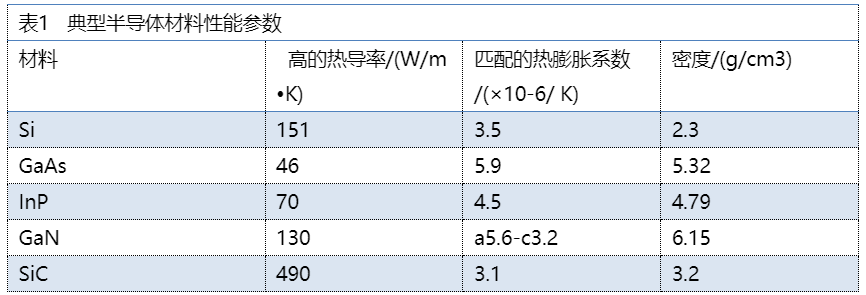
半导体材料通常具有较低的热膨胀系数,功率半导体芯片在工作时会有高的热量散出。且随着第2代半导体材料的成熟应用以及第3代的开发,未来芯片功率提高会对散热提出更加迫切的需求。因此,电子封装热沉材料得到广泛研究和产业化应用。
热沉材料,由于要与芯片紧密贴装,需要考虑2大基本性能要求:高的热导率(thermal conductivity,TC)和匹配的热膨胀系数(coefficient of thermal expansion,CTE)。通过高热导率实现快速散热,保证芯片在适宜的温度下正常工作;通过匹配的热膨胀系数,减小热沉、芯片以及各封装材料之间的热应力,避免开裂脱离等导致芯片过烧的情况发生。热沉材料的升级和发展,实质是热导率和热膨胀系数不断优化的过程。用于芯片热沉的电子封装材料主要有金属型、陶瓷型2大类。
1.金属类封装材料
金属类封装材料发展经历了4代。第1代是以 Invar 和 Kovar 合金为代表的低膨胀系数合金,合金热导率只有11~17W/(m•K)。第2代是铜-钨(Cu-W)和Cu-钼(Mo)材料为代表的复合材料,达到约200W / (m • K) ,热膨胀系数约7.0×10-6/K,表现出较好的综合性能,是功率芯片封装的主选材料,但其较高的密度限制了其在某些领域的应用。第3代是以铝(Al)/Sip、Al/SiCp为代表的轻质、低膨胀复合材料,Al/Sip材料热导率只有约120~150W / (m• K),虽然热导率低、但可加工性、气密性、焊接性等综合性能好,而被大量用于制作射频功率器件封装壳体,而Al/SiCp材料热导率能达到220 W / (m • K) ,同时密度控制在约 3.0 g/cm3,虽然加工难度大、但良好的热导率也使其作为壳体材料或芯片热沉材料而被广泛使用。第4代是Dia/Cu、金刚石/铝(Dia/Al)等为代表的高导热、低膨胀复合材料,通过设计使其具有6×10-6~7×10-6/K的热膨胀系数,具有550~650W / (m • K)的热导率,可用于第2代、第3代半导体芯片器件上,用于高功率器件的热沉封装,帮助器件解决散热难题,实现稳定运转。金属类电子封装材料的性能对比详见表2。
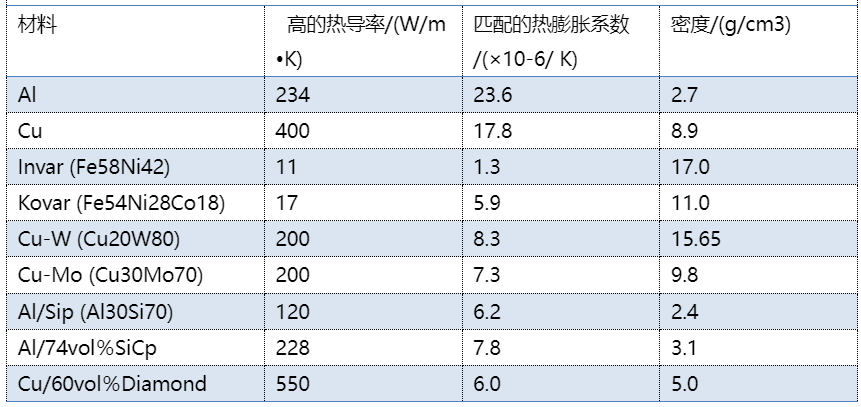
2.陶瓷类封装材料
陶瓷类封装材料以氮化铝(AlN)、氧化铍(BeO)等为代表被广泛应用。该类材料由于其陶瓷的特性,天然具有较低热膨胀系数,与半导体材料有很好的热匹配。但由于其分子间以共价键连接,通常热导率较低,限制了其在高导热芯片上的应用。
AlN材料是一种很好的高功率集成电路基片和包装材料,被广泛应用于芯片封装。AlN热导率约180W/(m·K),接近BeO和SiC,热膨胀系数4.5×10-6℃与Si(3.5×10-6~4×10-6/℃)和GaAs(6.0×10-6/℃)匹配,介电性能优良,机械性能和光传输特性好。BeO具有高的热导率、较低的热膨胀系数,受电子封装企业青睐,但是铍(Be)元素有毒性,BeO的制作过程和使用存在着很大的污染因素,因而许多设计者在选择高导热材料时,会避开BeO。SiC晶体具有更高的热导率和更低的热膨胀系数,但其造价高昂,单晶SiC通常作为半导体材料被研发以实现其经济效益。CVD-Diamond是采用化学气相沉积工艺制备的金刚石薄膜,虽然归在陶瓷类材料,但金刚石具有极高的热导率和强度,以薄膜的形式作为芯片热沉具有十分优异的散热性能,但造价成本极其高昂。陶瓷类电子封装材料的性能对比详见表3。

第2代、第3代芯片功率提高必然产生大量热。芯片需要热导率高,线膨胀系数匹配的材料来封装。金属Cu、Al具有高的热导率﹝398W/(m •K)、231W/(m •K))﹞,但其膨胀系数不匹配(17ppm/ K、23ppm/ K),若直接和芯片贴装,会因为热应力而脱离,进而引起芯片过烧。当高热导金属添加过量元素以期降低线膨胀系数时(Invar、Kovar),大量固溶元素影响材料晶格参数,降低声子传热性能,必然导致热导率急剧下降。W-Cu、Mo-Cu以两相复合材料的形式出现是一个跨越,但其热导率徘徊在200W/(m •K)。不足以满足日益增长的功率散热需求。
陶瓷类具有较低的热膨胀系数,但其热导率通常不高。单独使用无法满足散热的需求,热导率通常也局限在220W/(m •K)以下。虽然金刚石有极高的热导率﹝ (1 000~2 000W/(m •K)﹞,但应用于电子封装的CVD-Diamond金刚石薄膜材料的制备成本极其昂贵,其产业化之路将会更加遥远。
如何把金属的高热导率和陶瓷的低热膨胀系数结合,寻找较为经济的中间材料,是金刚石/铜被提出和研发的原因和动力。金刚石导热率高达2000W/(m •K),热膨胀系数低至2.3ppm/K,且目前金刚石颗粒已经规模化生产,相比CVD-Diamond薄膜,颗粒状金刚石成本极其低廉。Cu具有较高的热导率,且相比银(Ag)、金(Au)等贵金属,热导率相差不大,但价格很低。通过研究,结合二者优点,开发出一种金刚石/铜复合材料,可以将热沉材料的使用提高一个台阶,以适应芯片更高散热需求。
国内外关于Dia/Cu复合材料的研究始于2000年前后。美国率先开发它作为多芯片模块(MCM)的基板使用,热导率达420 W/(m •K),CTE为(5.48~6.5) ×10-6/℃;2002年日本开发成功,作为电子器件的热沉材料,热导率550 W/(m •K),CTE为6×10-6/℃;2007年瑞士采用气压熔渗法制备了金刚石/铜,热导率600 W/(m •K);2008年德国采用粉末冶金法制备了金刚石体积分数为50%的金刚石/铜复合材料,热导率642 W/(m •K);2007年,国内北京有色金属研究总院、北京科技大学、湖南大学等对金刚石/铜复合材料开始研究,热导率550~650W/(m •K),CTE为6×10-6/℃。
美国和日本在研究成熟后,率先实现产业化,应用于半导体激光器、射频功率器件等。国内,随着第2代、第3代半导体材料的发展,高功率芯片日益增多,对金刚石/铜热沉的需求量也呈现逐年增长态势。
目前,市场上出现的Dia/Cu,热导率550~650 W/(m •K)之间,热膨胀系数在5~7×10-6/℃之间。该材料目前应用集中在3个领域:半导体激光器、微波功率器件、高功率半导体照明。
半导体激光器的芯片是以GaAs、GaN等材料为衬底,热膨胀系数为5~6 ppm/℃。功率芯片需要一种热导率高、热膨胀系匹配的热沉材料配合使用。功率半导体激光器芯片本身体积小、厚度薄(0.1mm),在使用过程中会散发热量大。热沉和芯片热膨胀系数匹配,可以减小使用过程中冷热交替时产生热应力,从而减小芯片热沉脱离失效的几率。目前在激光器上使用的热沉材料有AlN、Al2O3、Cu-W、Cu-Mo、Diomond/Cu等。以垂直堆栈半导体激光器为例,目前采用的W-Cu、Mo-Cu热沉片热导率为200W(m •K)左右,满足单巴50W的要求。美国某公司采用Diamond/Cu复合材料作为热沉,热导率为500~650W/(m •K),能够实现单巴100W,而金刚石/铜热沉与芯片贴装的面积仅为15mm2。
微波功率放大器广泛应用在卫星通信、移动通信、导航、电子对抗、雷达系统等各种电子装备中,是通信和雷达系统等的重要组成部分。半导体器件是微波功率器件的核心部件,其芯片的散热管理影响到功率的发挥、器件稳定性和可靠性。目前,W-Cu、Mo-Cu主要担当热沉材料解决热传输的问题,随着器件向高功率发展,对热沉提出更高要求。金刚石/铜热沉材料有着W-Cu、Mo-Cu 2~3倍的热导率,将在提高半导体器件向高功率发展方面起着重要的作用。 目前大功率LED的解决方案有2个:一是通过增加单位面积内灯珠数量提高功率密度实现,二是通过增加单珠LED的功率实现。目前市场上多采用第1种方案,即提高单位面积灯珠数量来实现。通常热沉采用的是价格低廉的铝基衬板。而金刚石/铜针对的是第2种应用方案,即通过提高单珠功率实现。这对散热提出较高的要求。采用Dia/Cu衬底制备LED在技术上可以实现,但由于目前成本偏高,全面推广还需时日。 在目前大部分热沉材料及热管理方案无法满足高功率芯片散热需求的情况下,金刚石镀金属无疑是又一最佳选择。化合积电为客户提供专业、领先的金刚石散热方案,现有金刚石热沉片、晶圆级金刚石、金刚石热沉片镀金属等产品,在半导体激光器、功放器件、LED等领域的应用取得突破。