随着现代科学与技术的发展,硅材料在半导体制作上逐渐趋向物理极限,已经无法满足一些超高规格电子产品的苛刻条件,特别是针对射频芯片、功率器件在高频、高压、高功率的需求上,硅材料性能的限制尤为突出。因此,面临来自GaN,Ga2O3,SiC等为代表的新一代半导体材料的激烈竞争,伴随着一系列新兴技术正迅速崛起,关键材料及应用技术的突破将成为全球半导体产业新的战略高地。
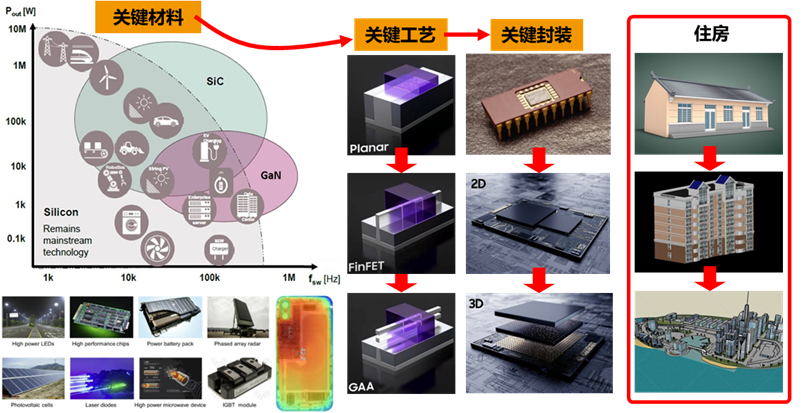
图1 半导体发展关键材料、关键工艺、关键封装技术概况。
如今,先进的封装工艺更被看作是为摩尔定律“续命”的最优解,也将提到芯片制造前端工艺甚至整个生产环节中去。而采用先进的封装技术将进一步缩短互连互通距离,提高集成度,具有封装体积小,互连线短,信号传输快,寄生电容和电感低,功耗低,可靠性和稳定性高等诸多优点。其中,为了满足高速计算、高密度存储器、低功耗、低封装外形的要求,3D堆叠技术将作为超越摩尔定律的重要研究和应用方向。例如结构简单的NAND闪存,已经大面积转向3D堆叠工艺,但3D堆叠工艺也不是万能的,散热就是要面临的一大难题,尤其是在三维封装中将面临更严重的“蓄热”以及多芯片间“协同热设计”等问题,极大限制了芯片从单片平面封装走向更先进的合封、共封、2.5D、3D封装。
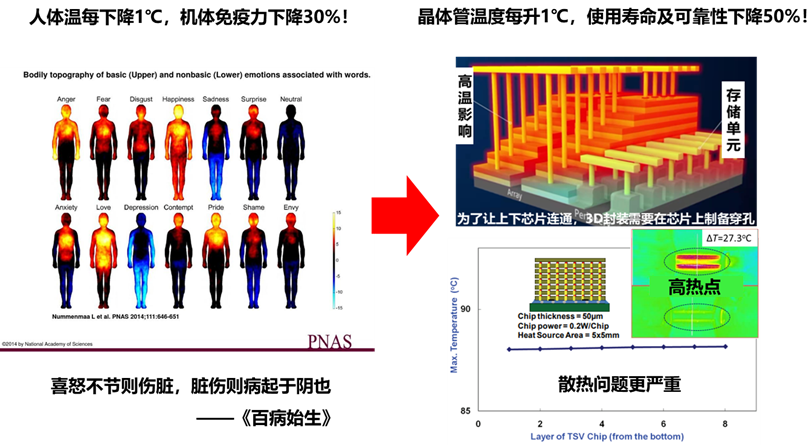
图2 人体以及芯片受温度影响示意图。
因此需要开发先进的散热技术,寻找合适的导热材料,为了保证热沉的正常工作、良好性能和使用寿命,必须考虑如导热系数、热膨胀系数、介电常数、电阻率、可金属化和机械可加工性等相关的物理化学性能。另外,对高导热材料的形状尺寸加工也有较高的要求,表面必须具有很高的平整度,以利于和热源器件良好的结合性能和保持热量传递通道畅通;厚度必须均匀,使得热量的耗散均匀而稳定。还需要具有较低的密度,可以在提高导热材料的导热系数的同时进一步减轻结构体积和重量。高导热材料的导热系数通常大于1200 W/m·K,还需同时满足密度低、膨胀系数小、导热率高、放气率低的要求。铝、金、铜等金属材料是热的良导体、它们的导热率分别为247 W/m·K、315 W/m·K、398 W/m·K,但还不能满足上述要求,铝密度低但导热率却不够高,且热膨胀系数较大,金、铜导热率较高,但密度较大。目前最具有潜力的轻质、高效、长寿命的高导热材料为碳基材料,主要包括碳/碳复合材料、石墨、石墨烯及金刚石薄膜材料。

化合积电(厦门)半导体科技有限公司是一家专注于第三代(宽禁带)半导体衬底材料和器件研发、生产和销售的高科技企业,致力于成为全球领先的宽禁带半导体材料和器件公司,核心产品是晶圆级金刚石、金刚石热沉片、金刚石基氮化镓异质集成、金刚石窗口片等。公司具备MPCVD设备设计能力,国内首家掌握MPCVD制备高质量金刚石的核心工艺并实现量产, 并且独创基于等离子体辅助抛光的金刚石原子级表面高效精密加工方法,全球首家将金刚石热沉片表面粗糙度从数十微米级别降低至1nm以下,达到半导体级应用标准。采用金刚石热沉的大功率半导体激光器已经用于光通信,在激光二极管、功率晶体管、电子封装材料等领域也都有应用。基于晶圆级的金刚石产品能力,公司开发出了金刚石基氮化镓异质集成方案,主要应用在射频(卫星、5G基站)与高功率器件(光伏、风力发电、新能源车、储能)等对热管理需求高的领域,作为碳化硅基氮化镓材料的补充。