芯片封装基板是一种用于承载芯片的线路板,它可为芯片提供电连接、保护、支撑、散热、组装等功效。随着芯片封装小型化、轻薄化、高性能化的需求日益增长;芯片功率增加,散热问题越来越突出;以及封装基板制造环保和可持续发展,传统的封装技术已经难以满足这些要求。因此,未来封装基板技术将朝着小型化、轻薄化、高性能化、高导热性、环保化的方向发展,金刚石等具有高导热性能的热沉材料将得到更广泛的应用。
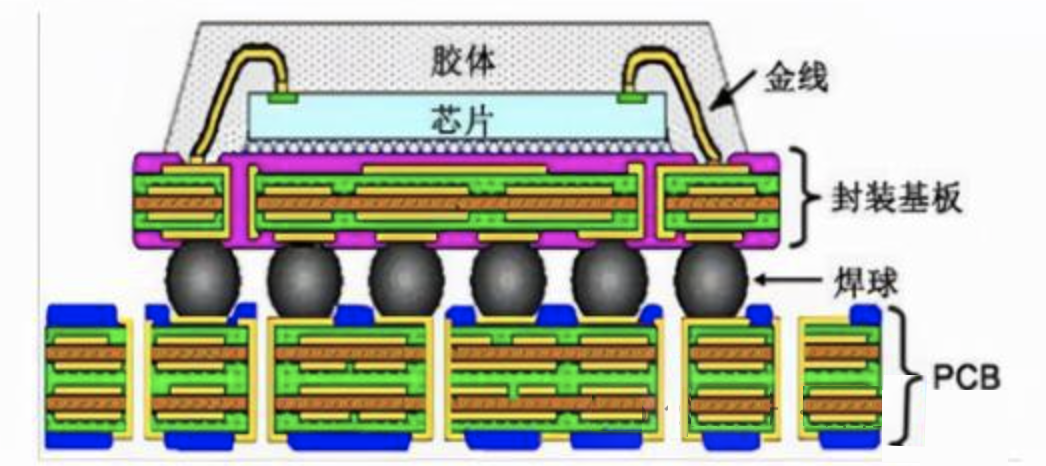
目前,封装基板技术已经成为电子封装领域的重要技术之一,被广泛应用于各种集成电路的封装中,包括CPU、GPU、存储器等。一般的封装基板有Al2O3陶瓷、SiC陶瓷、AlN材料等,但是Al2O3的热膨胀系数 (7.2×10-6/℃) 和介电常数 (9.7) 相对Si单晶而言偏高, 热导率 (15-35W/ (m·K)) 仍然不够高, 导致Al2O3陶瓷基片并不适合在高频、大功率、超大规模集成电路中使用;SiC陶瓷的热导率很高,且SiC结晶的纯度越高, 热导率越大;SiC最大的缺点就是介电常数太高, 而且介电强度低, 从而限制了它的高频应用, 只适于低密度封装;AlN材料介电性能优良、化学性能稳定, 尤其是它的热膨胀系数与硅较匹配等特点使其能够作为很有发展前景的半导体封装基板材料, 但热导率目前最高也只能260W/ (m·K),随着半导体封装对散热的要求越来越高,AlN材料也有一定的发展瓶颈。
而金刚石是目前已知自然界中热导率最高的物质,单晶金刚石的热导率为2200~2600 W/(m.K),多晶金刚石的热导率1000-2200W/(m.K), 热膨胀系数约为1.1×10-6/℃ ,在半导体、光学等方面具有很多优良特性,成本较高,但其优胜于其他陶瓷基板材料数十倍甚至上百倍的热导率,金刚石热沉片,将是芯片封装基板中的绝佳选择!

化合积电致力于金刚石等热沉材料研究,掌握国际领先的金刚石热管理产品和解决方案,现有核心产品晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石异质集成复合衬底等。其中,晶圆级金刚石生长面表面粗糙度Ra<1nm;金刚石热沉片热导率高达1000-2200W/m.k,技术指标皆达世界领先水平。金刚石热沉片在大功率电子器件、5G基站、新能源汽车、航空航天等诸多领域皆有应用。