提交需求,联系我们
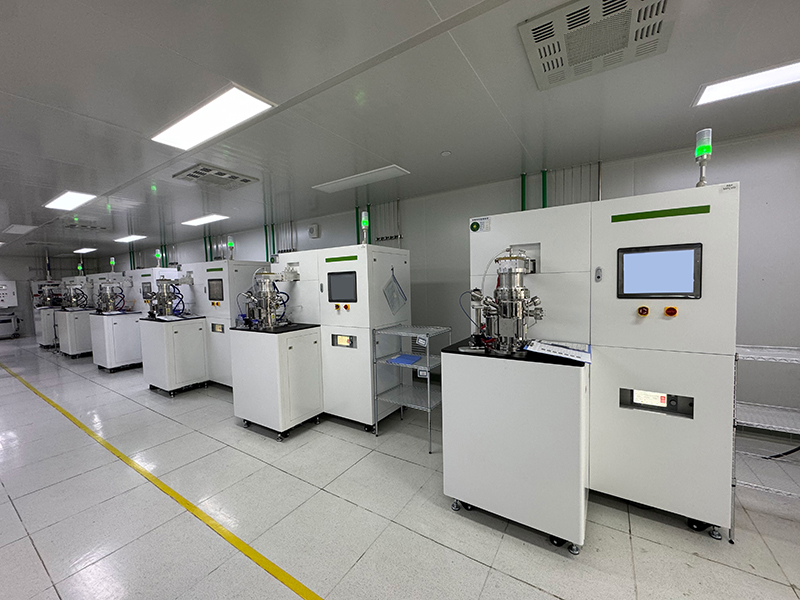
功能性指标要求:
(1)微波源产生高频微波并通过波导进入反应腔激发高纯氢气产生等离子,通过控制腔内温度、压力使甲烷气体中碳元素沉积到生长台的金刚石晶片上完成半导体级单晶金刚石外延。
(2)波导系统为金属波导(包括销钉调节器、波导管等),反应腔体为双层水冷不锈钢反应腔,基片台为升降式水冷基片台。
(3)配旋转真空无油泵、涡轮分子泵,配高真空计,能显示反应腔真空度。
(4)配高精度流量计及流量控制阀,每一路气体均具有吹扫旁路的能力,通过吹扫实现管路自清洁,保证后续气体的纯度的能力。
(5)配红外测温系统,能显示基台、样品温度。
(6)标准衬底托为钼盘,可以实现金刚石样品一次生长和多次连续生长,能从四个方向观察反应腔样品。
(7)配冷水机,能使用冷却水系统对系统的反应腔、基台、微波电源等组件进行冷却,保证设备正常工作。
(8)配系统软件,配液晶触摸屏幕、PLC全自动控制系统,能对沉积过程程序控制,具备保险装置、报警单元和紧急关机功能,具备远程故障报警功能。
技术性指标要求
| 序号 | 名称 | 具体技术指标要求 | |
1 | 微波系统 | 微波频率 | 2450±25 MHz |
★输出功率 | ≥ 6 kW(0.6-6 kW连续可调) | ||
★输出功率稳定度 | < 1% | ||
★微波泄露功率密度 | ≤2 mW/cm2(表面5cm处) | ||
2 | 反应腔体 | ★真空漏率 | ≤ 4 Pa/h |
观察窗口 | ≥4个 | ||
3 | 真空系统 | 工作气压范围 | 1-33 kPa |
★自动压力控制精度 | ± 15 Pa | ||
旋转真空无油泵抽速 | ≥ 20 m³/h | ||
涡轮分子泵抽速 | ≥ 400 L/s | ||
★真空系统漏率 | ≤ 1.0×10-9 Pa·m3/s | ||
每12小时压升 | ≤ 30 Pa | ||
本底极限真空 | ≤ 0.5 Pa (借助分子泵极限真空≤1×10-5 Pa) | ||
★高真空计显示精度 | ± 0.01 Pa | ||
4 | 样品台 | ★基片台高度调节精度 | ±0.1 mm |
标准衬底托尺寸 | ≥ 2" | ||
有效沉积直径 | ≥ Ф50 mm | ||
5 | 水冷系统 | ★冷却水流量 | >20 L/min |
★冷水机液温控制范围 | 5-30 ℃ | ||
冷却水控制精度 | ± 1.0 ℃ (实际温度与设定温度的误差<± 1.0 ℃) | ||
6 | 气路系统 | 流量计控制精度 | ± 2% |
≥6路 | |||
★气体管路流量范围 | (1)H2,流量范围: 1000 sccm (2)CH4,流量范围: 100 sccm (3)N2,流量范围: 10 sccm (4)O2,流量范围: 10 sccm (5)B2H6,流量范围: 10 sccm (6)备用,流量范围: 10 sccm | ||
7 | 测温系统 | ★测温范围 | 250-1400 ℃ |
测温控制精度 | ± 2 ℃ | ||
8 | 程序控制系统 | 无人值守时间 | ≥10 h |
| 序号 | 名称 | 具体技术指标要求 | |
| 1 | 微波系统 | 微波频率 | 2450±25 MHz |
| ★输出功率 | ≥ 10 kW(1-10 kW连续可调) | ||
| ★输出功率稳定度 | < 1% | ||
| ★微波泄露功率密度 | ≤2 mW/cm2(表面5cm处) | ||
| 2 | 反应腔体 | ★真空漏率 | ≤ 4 Pa/h |
| 观察窗口 | ≥4个 | ||
| 3 | 真空系统 | 工作气压范围 | 1-33 kPa |
| ★自动压力控制精度 | ± 15 Pa | ||
| 旋转真空无油泵抽速 | ≥ 20 m³/h | ||
| 涡轮分子泵抽速 | ≥ 400 L/s | ||
| ★真空系统漏率 | ≤ 1.0×10-9 Pa·m3/s | ||
| 每12小时压升 | ≤ 30 Pa | ||
| 本底极限真空 | ≤ 1 Pa(借助分子泵极限真空≤1×10-5 Pa) | ||
| ★高真空计显示精度 | ± 0.01 Pa | ||
| 4 | 样品台 | ★基片台高度调节精度 | ±0.1 mm |
| 标准衬底托尺寸 | ≥ 3" | ||
| 有效沉积直径 | ≥ Ф75 mm | ||
| 5 | 水冷系统 | ★冷却水流量 | >40 L/min |
| ★冷水机液温控制范围 | 5-30 ℃ | ||
| 冷却水控制精度 | ± 1.0 ℃ (实际温度与设定温度的误差<± 1.0 ℃) | ||
| 6 | 气路系统 | 流量计控制精度 | ± 2% |
| ★MFC气路数量 | ≥6路 | ||
| ★气体管路流量范围 | (1)H2,流量范围: 1000 sccm (2)CH4,流量范围: 100 sccm (3)N2,流量范围: 10 sccm (4)O2,流量范围: 10 (5)B2H6,流量范围: 10 sccm (6)备用,流量范围: 10 sccm | ||
| 7 | 测温系统 | ★测温范围 | 250-1400 ℃ |
| 测温控制精度 | ± 2 ℃ | ||
| 8 | 程序控制系统 | 无人值守时间 | ≥10 h |
| 序号 | 名称 | 具体技术指标要求 | |
| 1 | 微波系统 | 微波频率 | 915±15 MHz |
| ★输出功率 | ≥ 25 kW(2-25 kW连续可调) | ||
| ★输出功率稳定度 | < 0.25% | ||
| ★微波泄露功率密度 | ≤2 mW/cm2(表面5cm处) | ||
| 2 | 反应腔体 | ★真空漏率 | ≤ 6 Pa/h |
| 观察窗口 | ≥4个 | ||
| 3 | 真空系统 | 工作气压范围 | 1-33 kPa |
| ★自动压力控制精度 | ± 15 Pa | ||
| 旋转真空无油泵抽速 | ≥ 20 m³/h | ||
| 涡轮分子泵抽速 | ≥ 400 L/s | ||
| ★真空系统漏率 | ≤ 1.0×10-9 Pa·m3/s | ||
| 每12小时压升 | ≤ 50 Pa | ||
| 本底极限真空 | ≤ 1 Pa(借助分子泵极限真空≤1×10-5 Pa) | ||
| ★高真空计显示精度 | ± 0.01 Pa | ||
| 4 | 样品台 | ★基片台高度调节精度 | ±0.1 mm |
| 标准衬底托尺寸 | ≥ 5" | ||
| 有效沉积直径 | ≥ Ф125 mm | ||
| 5 | 水冷系统 | ★冷却水流量 | >80 L/min |
| ★冷水机液温控制范围 | 5-30 ℃ | ||
| 冷却水控制精度 | ± 1.0 ℃ (实际温度与设定温度的误差<± 1.0 ℃) | ||
| 6 | 气路系统 | 流量计控制精度 | ± 2% |
| ★MFC气路数量 | ≥6路 | ||
| ★气体管路流量范围 | (1)H2,流量范围: 2000 sccm (2)CH4,流量范围: 200 sccm (3)N2,流量范围: 20 sccm (4)O2,流量范围: 20 sccm (5)B2H6,流量范围: 20 sccm (6)备用,流量范围: 20 sccm | ||
| 7 | 测温系统 | ★测温范围 | 250-1400 ℃ |
| 测温控制精度 | ± 2 ℃ | ||
| 8 | 程序控制系统 | 无人值守时间 | ≥10 h |
应用领域
更多应用