金刚石的热导率高达 2 000 W/ ( m·K) ,是 自然界中热导率最高的材料,因此金刚石逐渐成为 GaN 器件封装材料的首选。近年来金刚石作为 GaN 器件的热沉材料和衬底材料,其技术和应用均取得较大进展。传统材料的热导率已无法满足高功率密度芯片的散热需求,新型高热导率材料的开发和应用成为技术关键。在 GaN 基 HEMT 器件上添加金刚石作为衬底材料,实验结果表明,添加金刚石后有效降低了器件沟道温度,提高了器件饱和漏源电流。
放大器的封装结构模型如图 1 所示,模型主要包括两个 GaN 功率芯片、Au80Sn20 焊接层、载片、印制电路板 ( PCB) 、In80Pb15Ag5 焊接层 和盒体。
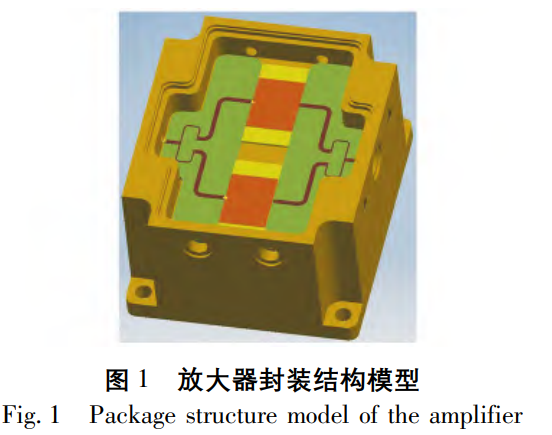
为了降低芯片的工作结温,基本理念是提高芯 片有源区近端封装体的热导率,通过热传导的方式 将热量迅速传输出去,避免热累积效应引起的局部 温度升高。图 2 为传热模型示意图,可以看出,距 离芯片最近的封装结构为载片,因此对超高热导率 的载片材料的研制具有重要意义。
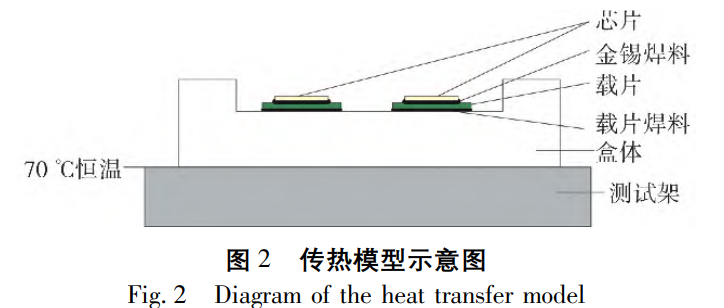
GaN 功率器件常用的载片材料有钨铜 ( WCu15 ) 、钼 铜 ( MoCu30 ) 、 无 氧 铜 ( TU1 ) 、 铜-钼铜-铜多层复合材料 ( Cu-MoCu-Cu,CPC) 等,传统材料的热导率均较低,GaN 功率放大器 最常用的载片材料为钼铜合金 ( MoCu30) ,其热导 率为 185 W/ ( m·K) 。采用高热导率的金刚石作为载片,由于金刚石本身是绝缘材料,利用通孔电镀方式实现导通接地,同时解决了金刚石表面可焊性镀 层的制备问题,金刚石载片与 Au80Sn20 焊料润湿 性良好,空洞率控制在 5%以内。
通过热仿真,采用 MoCu30 载片的芯片结温为 159. 17 ℃,采用金刚石 载片 的 芯 片 结 温 为 126. 91 ℃,金 刚 石 载 片 较 MoCu30 载片封装的放大器结温下降了 32. 26 ℃。
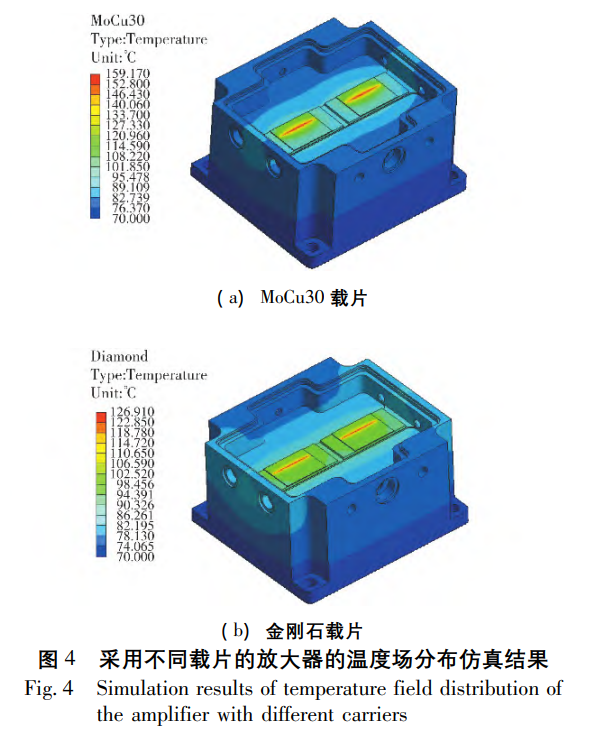
金刚石作为新一代电子封装材料,受到广泛重 视,是最有潜力的封装材料之一。本文通过有限元 仿真与红外测试相结合的方法,分析了采用常规载 片材料 MoCu30 与新型载片材料金刚石载片封装的 功率放大器结温。结果显示,金刚石载片封装的放大器结温降低了 30. 01 ℃,约 18. 69%。进一步利 用有限元仿真对金刚石与其他 4 种材料在不同热耗 条件下的散热效果进行了对比,结果表明金刚石散 热效果最好,可满足近 100 W 热耗的散热需求, 这对延长芯片使用寿命,提高功率器件热可靠性具 有重要意义。

当器件温度上升时,器件特性如漏源电流、增益、输出功率和寿命等会出现退化,甚 至失效。研究表明,结温每升高 10 ~ 12 ℃,器件 的寿命及可靠性会降低 50%,散热问题已经成为限制 GaN 功率器件发展的主要瓶颈之一,为解决此问题,提出了多种降低器件温度的散热方式, 其中新型电子封装材料的研究开发成为解决 GaN 功率器件散热问题的技术关键。化合积电金刚石热沉片的热导率1000- 2200 W/ ( m·K) ,是 GaN 器件封装材料的首选。欢迎进行详细咨询和洽谈。