后摩尔时代,芯片采用 “堆叠架构”(如 2.5D/3D 封装、高带宽内存封装),推动先进电子封装材料需同时满足四大核心需求:电稳定性:高体积电阻率(避免堆叠结构漏电);EMI 屏蔽:抑制高频信号串扰(传统依赖高导电性,易引发电可靠性风险);热管理:高导热率(解决高功率芯片散热);低热膨胀:低 CTE(减少与硅基板 / 芯片的热膨胀失配,降低翘曲)。
随着电子封装进入高密度、高频率的新时代,传统的以高电导率为基础的电磁干扰屏蔽(EMI)方法面临着电气可靠性失效的严重风险。
通过液相反应调节前驱体浓度,制备出具有因瓦效应的二氧化硅包覆铁镍球形颗粒,并实现对包覆层厚度的精准调控。对SiO₂层的有效控制阻隔了复合材料中的电子传输,同时保留了磁网络结构与声子传导路径。FeNi@SiO₂/EP复合材料成功展现出高电绝缘性(电阻率超过10¹² Ω·cm)、优异电磁干扰屏蔽效能(约30 dB)及良好导热性能。
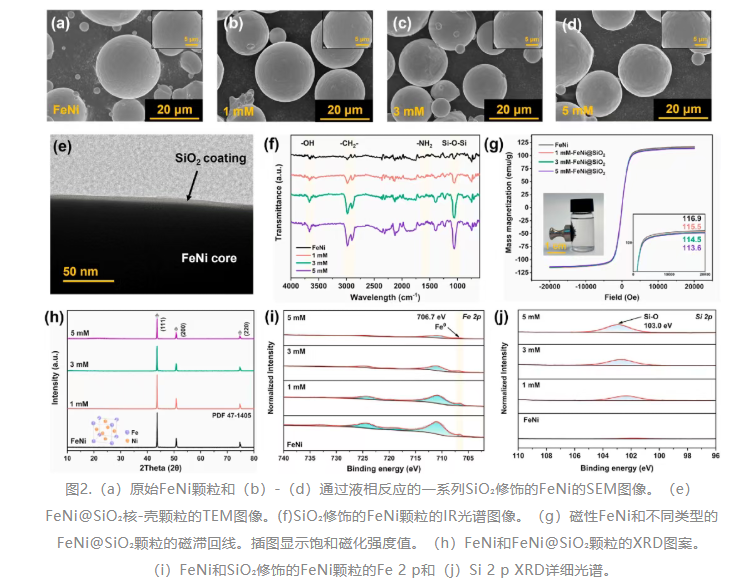
其电磁屏蔽机制主要源于铁镍颗粒的局部涡流损耗、连续磁网络诱导的磁损耗,以及多相界面处的介电损耗。值得注意的是,铁镍颗粒的近零热膨胀特性使复合材料具有较低的热膨胀系数(7-8 ppm/°C)。这些创新成果有望显著推动电子器件向更高集成度与小型化方向发展,尤其在电绝缘型电磁干扰屏蔽材料领域具有重要应用价值。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂、氮掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。