现代微电子技术发展迅猛,电子系统及设备正朝着大规模集成化、微型化、高效率、高可靠性的方向演进。随着电子系统集成度不断提升,功率密度随之增高,电子元件及系统整体工作时产生的热量也显著增加,因此,有效的封装设计必须解决电子系统的散热难题。
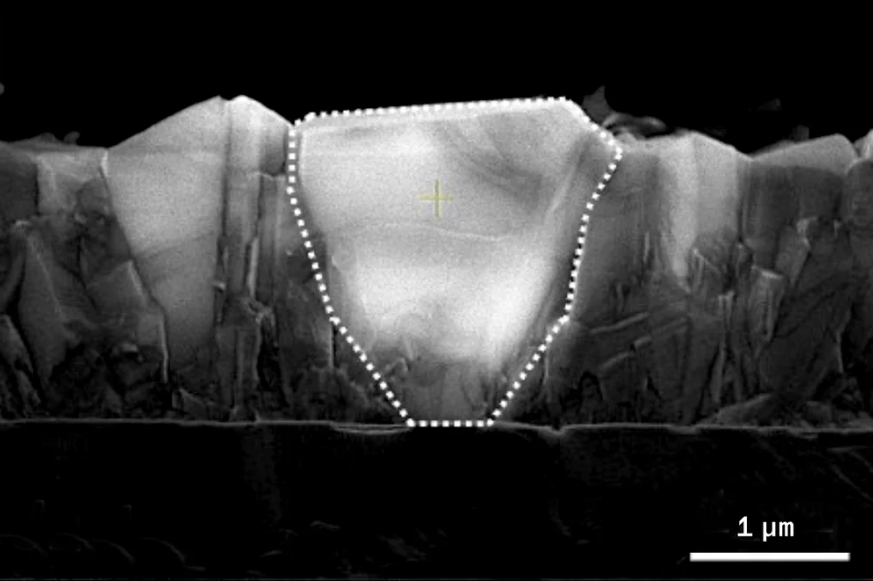
良好的器件散热依赖于优化的散热结构设计、封装材料选择(热界面材料与散热基板)及封装制造工艺等。其中,基板材料的选用是关键环节,直接影响到器件成本、性能与可靠性。当前电子封装领域广泛采用陶瓷基板(载板)作为芯片的封装基底,包括氧化铝、碳化硅、氮化铝、氮化硅等材料。
Al2O3的热膨胀系数和介电常数高于Si单晶,热导率不足,不适用于高频、大功率、超大规模集成电路;SiC陶瓷的热导率很高,但介电常数太高、介电强度低,限制了它的高频应用,只适于低密度封装;AlN材料介电性能优良、化学性能稳定,热膨胀系数与硅匹配,是极具前景的半导体封装基板材料,但高端AlN原料需要从国外进口;Si3N4陶瓷机械强度高、耐热冲击好,但其热导率相对较低,介电常数亦在8-9附近,难以充分满足高功率密度、小型化封装对高导热的极致要求。
在此背景下,化学气相沉积(CVD)金刚石因兼具超高热导率与优异稳定性,正逐渐成为新一代封装载板材料的关注焦点。
业界尝试将金刚石应用于高功率器件散热基底,主要形式分为两类:一是直接沉积金刚石薄膜作为基板,二是金刚石与铜/铝等高导热金属复合形成复合基板。
化合积电可显著提升封装基板导热性能,还能制备厚度可控的超薄结构;其金刚石膜异质衬底生长与剥离工艺可靠,能让薄膜便捷脱离生长基底获得独立载板;同时增强载板表面金属化附着力,支持基板表面高密度电路图案化,进一步提高封装可靠性。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂、氮掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。