随着设备变得越来越小,它们在存在极端功率密度(大于 1 kW/cm 2)时仍然需要高可靠性。这就产生了对新的热管理解决方案的需求。这一点在氮化镓 (GaN) 晶体管的使用中表现得最为明显,在这种情况下,工程师们正在努力解决限制实现 GaN 半导体器件固有性能潜力的能力的热障。金刚石热沉片是应对这一 GaN 热管理挑战的常见解决方案。
基于 GaN 的晶体管及其相关射频 (RF) 功率放大器 (PA) 已成为替代雷达、电子战 (EW) 系统和卫星通信中的行波管的领先固态技术。然而,GaN 高电子迁移率晶体管 (HEMT) 在硅芯片上的运行对热管理提出了重大挑战,因为热量产生集中在非常小的区域,通常以微米为单位。典型 GaN HEMT 器件中的栅极间距通常小于 50 µm。这会导致显着的热梯度和高工作温度,从而影响设备性能和耐用性。升高的温度会对可靠性产生不利影响。作为结果,有效的热管理对于 GaN 器件至关重要,并且对于充分发挥其潜力非常重要。正如在之前的研究中发现的那样,微通道和微射流散热器都可以消散大功率电子设备中预期的高热通量。消散高集中热通量需要有效的散热能力。CVD 金刚石热沉片特别适合此类应用。
金刚石拥有一系列非凡的特性,包括: 已知最高的导热性、刚度和硬度;在很宽的波长范围内具有高光传输率;低热膨胀系数;和低密度。这些特性可以使金刚石成为热管理的首选材料,以显着降低各种应用中的热阻。CVD 金刚石现在可以很容易地买到不同等级的产品,导热系数范围从 1000 W/mK 到 2200 W/mK。CVD 金刚石还具有完全各向同性的特性,可以增强各个方向的热量传播。当采用适当的芯片贴装方法时,金刚石热沉片可为具有重大热管理挑战的半导体封装提供可靠的解决方案。

实验测试在200μm厚度的热测试芯片上进行。芯片加热功率范围为 10W 至 100W,由八个热点加热器(每个尺寸为 450 × 300μm 2)产生。微型冷却器的流速为 400 毫升/分钟,需要的泵送功率为 0.2W。

假定所用焊接材料共晶金/锡 (Au/Sn) 的热导率恒定为 57 W/mK。假定硅和金刚石接触界面之间有 5μm 厚的 Au/Sn 键合层。芯片热通量仅在热点加热器上。

在没有金刚石热沉片的情况下,该结构可以耗散 30W 的加热功率(热点热通量 2.8 kW/cm 2)和 70W(6.5 kW/cm 2),同时将最大热点温度(在芯片表面测量)保持在 80ºC 和180ºC,分别。使用金刚石热沉片,散热量显着提高到 5 kW/cm 2(对于 54W)和 6.5 kW/cm 2(在 70W 加热功率时)。在这两种情况下,最高热点温度都降低了大约 26%。为了将芯片温度保持在 180˚C 以下,具有金刚石热沉片的结构可以耗散大约 100W 的热功率(热点热通量 9.2 kW/cm 2)。没有金刚石,功耗降低到 70W。
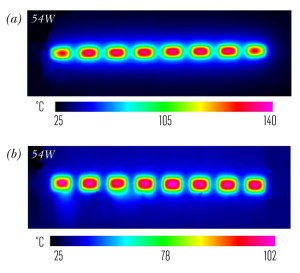
对于 54W (5 kW/cm 2 )的芯片功耗,在使用和不使用 CVD 金刚石热沉片的情况下,如图显示了芯片顶部表面测得的温度分布。位于芯片边缘附近的测量热点的最高温度比没有金刚石热沉片的结构中心低 8ºC。包括金刚石热沉片会导致靠近芯片边缘和中心的热点之间出现 2ºC 的峰值温差。

在100μm厚度的热测试芯片上进行了额外的实验测试和模拟。图6显示了热效应的比较结果。与图 3中的结果相比,在没有金刚石热沉片的情况下,通过将芯片厚度从 200μm 减小到 100μm,只能使温度略有下降。70W加热,最高温度下降不到2%。然而,使用 100μm 的芯片厚度,热源和热沉片之间的热阻较小,将改善散热。金刚石热沉片可散发 110W 的加热功率(10.2 kW/cm 2) 同时将最高热点温度保持在 160ºC 以下。为了散发 70W 的加热功率,钻石散热器可以将最高热点温度降低 40%。还应该注意的是,当使用 CVD 金刚石时,该结构的硅微冷却器顶面上的热通量分布会发生显着变化。最大热通量从2.66kW/cm 2降低到大约0.39kW/cm 2。整个散热结构的最大热阻,与总发热功率和散热结构的最高温度有关,采用金刚石热沉片进行热点热管理,可降低73%。

增加热沉片厚度会导致温度和热通量降低。通过将厚度从 400μm 增加到 700μm,热性能仅略有改善,但在 100μm 到 400μm 之间的厚度范围内更明显,其中最大热点温度和热通量可分别降低约 12% 和 63% . 改变热沉片厚度也会影响温度分布。对于110W功率加热,热沉片厚度为100μm、400μm和700μm时热点的峰值温度变化率分别为6.9%、3.2%和2.6%。

一个在芯片和热沉片之间,另一个在微型冷却器和热沉片之间。这些层对于确保低热阻至关重要。在实验测试中,两个键合层的厚度约为5μm。图 8 显示了从硅热芯片到微型冷却器的垂直预测温度分布。为了耗散 110W 功率,芯片-金刚石结合层的温升约为 8.1ºC,而金刚石-冷却器结合层的温升可以忽略不计。散热器顶部的粘合层距离热源更近,对热点冷却有更强的影响。额外的模拟表明,热性能对芯片-金刚石界面处的结合层厚度非常敏感。厚度从5μm增加到10μm,温升将增加8.8%,从5μm增加到20μm,温升将增加12.9%。通过将金刚石-冷却器界面处的结合层厚度加倍或增加四倍,预计不会出现显着的温度升高。
对于芯片散热70W的热功率,导热系数为2000W/mK和1500W/mK的金刚石散热器可以分别降低最高热点温度40%和38%。一个 2000 W/mK 的金刚石散热器可以散发 110W 的加热功率(热点热通量为 10.2kW/cm 2) 同时将最高热点温度保持在 160ºC 以下。
化合积电提供专业领先的金刚石热管理产品和解决方案,就金刚石热沉片推出四款标准产品,TC1200、TC1500、TC1800和TC2000等,为硅基芯片、砷化镓芯片、氮化镓芯片等散热提供全球领先的热管理方案,欢迎进行详洽。