近年来,随着 GaN 微波功率器件的设计和工艺不断提高和改进,其理论输出功率越来越高(4 GHz,~40 W/mm),频率越来越大,体积越来越小,其可靠性和稳定性受到严重挑战。最主要的原因是 GaN 基功率器件随着功率密度的增加,芯片有源区的热积累效应迅速增加,导致其各项性能指标迅速恶化,使其大功率优势未能充分发挥。因此,散热问题成为制约 GaN 基功率器件进一步发展和广泛应用的主要技术瓶颈之一。受传统封装散热技术的限制无法解决这一难题,必须从 GaN 器件近端结热区着手提升其热传输能力,因此探讨 GaN 基器件的高效散热课题成为其进一步推进 GaN 器件发展的重要方向。
金刚石拥有最高的导热性,使其成为一种优越的散热衬底,逐渐成为 GaN 器件热沉材料的首选。研究人员曾试图通过将GaN和金刚石用某种形式的过渡层或粘附层结合,来创造一种GaN-on-diamond结构,但在这两种情况下,额外的中间层都严重干扰了金刚石的导热性,从而破坏了GaN-diamond组合的一个关键优势。因此,需要一种可以直接集成钻石和氮化镓的技术。然而,由于它们的晶体结构和晶格常数的巨大差异,在GaN上直接生长金刚石或在金刚石生长GaN极其困难。
日本大阪公立大学梁剑波教授课题组,在室温条件下,使用表面活化键合法成功将硅衬底上外延生长的氮化镓层转移到金刚石衬底上,并实现1000°C的热处理保持键合。表面活化键合法(SAB)即在腔体内冲入氩气同时利用中性原子束,在室温下达成了氮化镓-金刚石键合。由于键合界面可以承受1000°C的热处理,因此通过对与金刚石键合的GaN层进行加工,有望实现金刚石的热导率最大化的GaN器件。梁教授课题组实验过程中主要涉及到的设备是表面活化键合设备,实验原材料为硅衬底的氮化镓薄膜衬底、高温高压合成金刚石(4*4mm),通过先用表面研磨法研磨金刚石,使其粗糙度变得更低,能够更好的与硅衬底上的氮化镓薄膜相接处,在研磨之后再通过化学清洗,清洗表面的不纯物,使其表面达到完美清洁度,然后导入键合设备中进行键合。键合是使用两个等离子腔同时进行金刚石和氮化镓表面活性化处理,由于金刚石的硬度远高于氮化镓的,所以两者表面活化处理的能量和气体是不一样的。
键合完成后,通过机械抛光和湿法蚀刻去除底部硅衬底,获得氮化镓和金刚石键合面,然后进行700℃退火。通过该实验表明氮化镓与金刚石键合面能够承受氮化镓器件需要承受的苛刻制造工艺,具有较高的机械稳定性。

通过对氮化镓和金刚石键合面热处理前、700℃热处理后、1000℃热处理后的结构与能谱仪成分分析对比发现,热处理前,氮化镓和金刚石键合界面处形成了一层厚度约为5.3nm的中间层,这是无定形碳和金刚石组成的混合层。随着退火温度的升高,中间层中的无定形碳直接转化为金刚石,中间层厚度随着退火温度的升高而减少。在1000℃退火后,中间层厚度减少到1.5nm左右,并出现晶格条纹。
通过检测氮化镓和金刚石键合面的电流-电压特性,证明同硅衬底上氮化镓器件相比,氮化镓与金刚石器件具有更高的输出性能,因为表面活化键合的金刚石更好的解决散热问题。
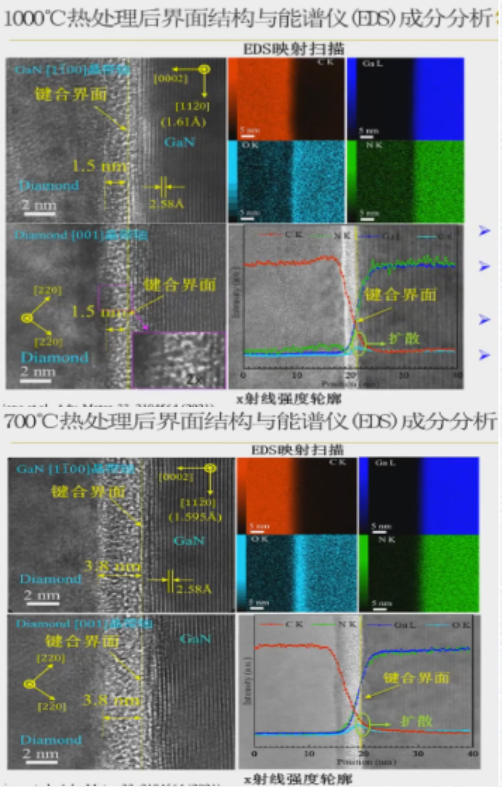
日本大阪公立大学梁剑波教授课题组,创新的在室温条件下,使用表面活化键合法成功将硅衬底上外延生长的氮化镓层转移到金刚石衬底上,并实现1000°C的热处理保持键合。克服了以往GaN和金刚石用某种形式的过渡层或粘附层结合导致无法最大发挥金刚石散热特性的缺陷。
化合积电一直专注于金刚石材料的研发、生产和销售,已有成熟产品晶圆级金刚石、金刚石热沉片、金刚石基异质集成复合衬底等产品。面向市场,推出金刚石和氮化镓异质集成复合衬底,欢迎进行沟通交流。