所有电力电子设备在正常运行时都会产生大量热量,更快的开关频率和更高的电流密度意味着更大量的热循环。芯片异质结结温升高,会降低漏极电流,影响器件性能。随着电流密度的增加,由于器件运行产生的自热效应,通道温度会比环境温度高出几百度。自热效应会导致器件性能恶化甚至烧毁金属线,是降低器件寿命和可靠性的关键因素之一 。
如图所示,图中对比了硅、碳化硅及氮化镓的材料性能。可以看出,氮化镓相对于碳化硅最大的缺点是热传导能力不足。而GaN HEMT 瞬态升温曲线的测量结果,揭示了HEMT垂直方向的散热路径,并证明此路径由芯片连接材料及封装体本身为主导。因此需要更多区别于传统封装的手段来满足高频功率器件。
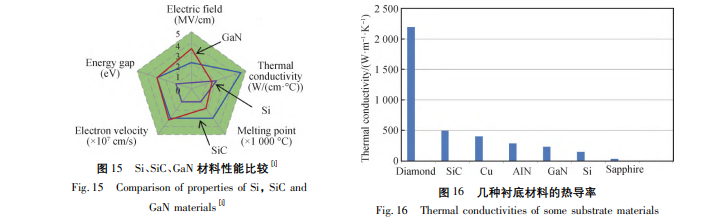
一种高导热、电绝缘的衬底是氮化镓高功率晶体管的理想衬底,如图所示为几种衬底材料的热导率。 由图可知,金刚石单晶的热导率最高,相比之下传统的 Si 或 SiC 衬底作为热沉衬底,虽能起到散热的作用,但两者的热导率( Si衬底热导率 191 W/( m·K) ,SiC热导率 490 W/( m·K)) 较低,散热效果欠佳。通过化学气相沉积得到的多晶金刚石热导率可达 1500 W/( m·K) ,是 SiC 的 3 倍之多,并且绝缘性能较好,因此使用金刚石作为衬底可以有效解决HEMT的散热问题。
HEMT 主要的热源在2DEG层产生,热点在栅极靠近漏极一侧,所以金刚石层越靠近有源区沟道层,散热效果越好,如图所示为HEMT热点位置及散热路径。
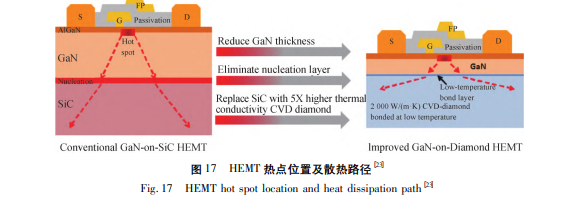
采用ANSYS进行有限元建模,比较了GaN-on-Diamond 和行业内标准 GaN-on-SiC 的热性能,结果如图18所示,在3倍的功耗下,新型 GaN-on-Diamond 器件的最大结温为 244 ℃,相比GaN-on-SiC器件降低了16 ℃。
目前金刚石与 GaN HEMT集成用于解决器件散热的研究中,较多的技术是将制备完成的 GaN HEMT从原有衬底上剥离下来,转移键合到金刚石衬底上。转移键合的方法与直接金刚石生长技术相比,在灵活性方面具有显著优势。将 GaN HEMT从主体 SiC 衬底上剥离下来,然后通过低温键合工艺(小于150℃) 将其转移到多晶CVD金刚石衬底上,得到的GaN-on-Diamond HEMT在10 GHz(CW)下,直流电流密度为 1.0 A/mm,跨导为 330 mS /mm,射频输出功率密度为6.0 W/mm。通过有限元热模型分析表明,与传统的 GaN-on-SiC器件相比,其单位面积功率提高了3倍。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。