近年来,随着电子器件性能的快速发展,有效清除集成电路芯片(如CPU和GPU)产生的热量对保证系统的持续、稳定和平稳运行越来越重要。为承担散热这一基本任务,将器件的工作温度维持在一个理想的水平,开发高传热性能的散热材料成为目前的一个研究热点。
目前,电子器件的功率急剧提高,现有的散热材料无法满足高导热、低膨胀系数、轻质、无污染等方面的需求。金刚石的热导率在常温下>2000Wm⁻¹K⁻¹,且因其优异的介电性能以及较低的热膨胀系数等诸多优异性能,是目前半导体器件的理想散热材料。若要使金刚石及其薄膜在半导体散热领域获得实际应用,则需解决硅(Si)、碳化硅(SiC)和氮化镓(GaN)等半导体器件与金刚石的有效连接问题,这是限制金刚石在半导体散热领域应用的最大难点。
金刚石具有超高热导率,若能与半导体直接连接,则可充分发挥金刚石热导率高的特性。金刚石和半导体器件的直接连接方式是先利用外延生长工艺在衬底上沉积半导体材料,然后去除衬底,并与金刚石衬底进行低温键合。一方面,该方案避免了直接外延生长需要的高温,降低了热膨胀失配导致的高密度位错;另一方面,该方法不需要沉积金刚石的氢等离子体环境,避免了半导体器件本征性能的降低。此外,无论是聚晶金刚石,还是单晶金刚石,都可作为低温键合的热沉基板,这大大降低了制备金刚石衬底的难度。而且,半导体外延层和金刚石热沉基板因可在键合前独立制备,故可精简金刚石基半导体器件工艺。
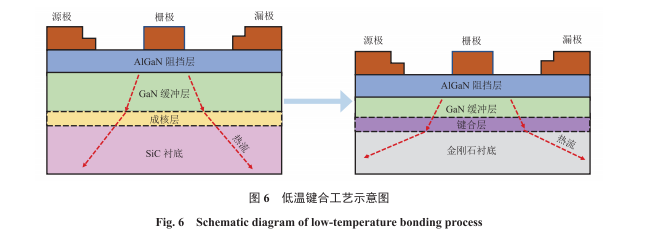
目前,金刚石基半导体器件工艺可在300℃以下,甚至室温,进行器件的直接键合,大幅提高了半导体器件的散热能力。在该方法中,GaN 缓冲层厚度减小,成核层被消除,SiC衬底通过低温键合技术被高导热性的金刚石代替。通过这种设计使GaN器件的热源在金刚石衬底的1mm内,显著降低了器件热阻。以一层SiN 作为结合界面层,其接触界面的热阻低至2.5x10-9m2·K·W-1。通过连续波直流测试发现,GaN HEMT转移到金刚石衬底上后,器件直流性能未发生明显退化,一定程度上说明了转移过程中的应力控制及键合界面热阻控制取得了成效。
Si、SiC和GaN等半导体与金刚石间的间接连接主要通过中间层进行连接,常见的中间层主要是Sn、Ag等金属层。虽然金刚石散热片最理想的应用方式是与芯片直连,但在现有的直连工艺下,金刚石与芯片间均或多或少存在一些中间界面层。例如:通过沉积工艺直连中的SiN.中间层,晶片直接键合中的Si或SiC中间层等。这些中间层的热导率较低,降低了金刚石的散热效果。与之相比,一些金属的热导率较高。利用金属进行芯片与基板间的连接,进而进行电子封装,在半导体行业是一种较成熟的工艺。
目前,金刚石热沉与半导体器件连接技术领域的关键是,如何实现高可靠性、高效率、低成本的大面积金刚石与半导体芯片的连接。尤其是在高功率、高温、高频、高压等极端环境下,如何保证金刚石与半导体芯片连接的稳定性和可靠性是一个重大挑战。
从国家战略发展角度来看,金刚石热沉因其一些独特的物理与化学性质(高热导率、高耐磨损性、高化学稳定性等),在高功率半导体器件、光电子器件、能源、航空航天等领域具有广泛的应用前景。加快金刚石热沉技术的研发和产业化将有助于提高国家的前沿技术竞争力和产业水平,以及推动我国经济转型和创新发展。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。