随着人工智能(AI) 与高性能计算(HPC) 的浪潮席卷全球,现代芯片的运算能力达到了前所未有的水准。然而,“性能越大,发热量越高” 的铁律,已成为电子产业持续发展中最棘手的挑战。
过度的热能使得系统不得不限制CPU 和GPU 的性能,以避免芯片老化。现在,“低温多晶金刚石薄膜”正以前所未有的方式,将热能进行具体散热管理。这项研究证明,将热导率极高的金刚石整合到芯片内部,距离晶体管仅数纳米之遥,有望重新定义跨行业的热管理策略。
根据研究报告指出,微型化是推动科技进步的核心追求,但这场竞赛已经演变成对抗热能的战役。随着晶体管越塞越多,散热的空间日益减少。热量不再能快速扩散,反而集中形成“热点”,这些区域的温度可能比芯片其他部分高出数十度。这种极端高温会导致晶体管泄漏更多电流、浪费电力,并加速芯片老化。
而在高性能计算领域,处理器需要持续提高功率密度(例如,新款Nvidia GPU B300 服务器预计将消耗近15千瓦的功率)。在通讯、功率电子等领域,也都面临热能限制。目前的冷却方案,如散热片、风扇、液体冷却(包括将服务器浸入专用的液体中散热) 等,虽然有所创新,但仍存在局限性。它们要么过于昂贵,只适用于最高性能的芯片,要么就是过于笨重。
更重要的是,随着业界转向3D 堆叠芯片架构(例如AMD 的MI300 系列和高带宽内存),传统的散热技术将远远不足。若无法从多层芯片中的每一层有效散热,堆叠式结构的3D 系统将难以维持其可行性。
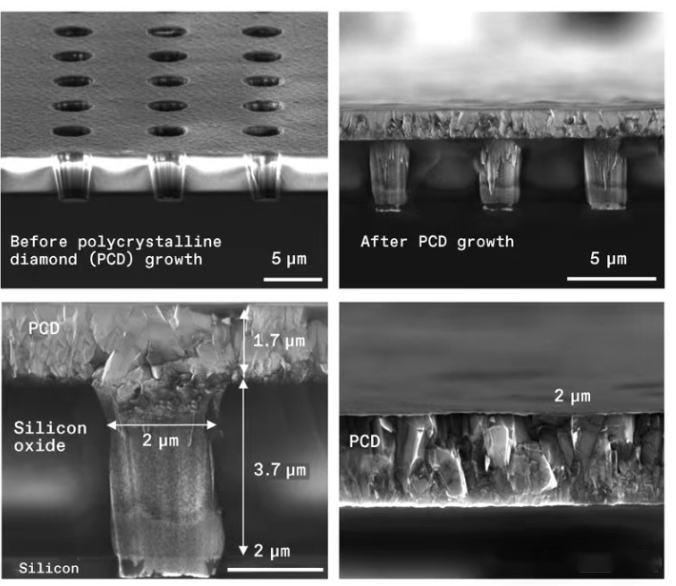
因为金刚石是地球上热导率最高的材料之一,效率比铜高出许多倍。同时金刚石还是电绝缘体,其单晶金刚石的热导率可达2,200 至2,400 瓦.米.开尔文,约为铜的六倍。即使是更容易制造的多晶金刚石,其性能也能接近这些数值。由于金刚石是电绝缘且介电常数相对较低,可充当“热介质”(thermal dielectric),使其在热传导的同时保持电绝缘性,不易造成信号衰减。
在金刚石和半导体的边界上,形成了一层薄薄的碳化硅,它充当了热量流入金刚石的桥梁。
为了实现低温生长,在传统的甲烷和氢气混合物中添加氧气,这有助于连续蚀刻掉非金刚石的碳沉积物。之后,经过大量的实验,他们找到了一种配方,能够在400 °C 的温度下,针对器件生成大晶粒多晶金刚石涂层。这个温度对于CMOS 电路和其他器件来说是可可以承受的。
将金刚石生长在以氮化硅覆盖的氮化镓(GaN)上时,实测的TBR 远低于预期。与碳化硅(Silicon Carbide, SiC)的形成是低TBR 的原因。而金刚石与氮化硅介面处的混合导致了碳化硅的生成,它充当了声子的“桥梁”,从而落实了更高效的热传导。这个科学发现立即产生了技术影响,就是通过碳化硅介面,器件的热性能显著提升。
氮化镓高电子迁移率晶体管(GaN HEMTs)中测试了这种低TBR 金刚石涂层。 GaN HEMTs 是一种理想的测试案例,因为其关键发热部分(二维电子气体)非常接近器件表面。且早期结果令人振奋,包括在GaN 射频晶体管中,添加金刚石后,器件温度下降了超过50 °C。在较低的温度下,这些晶体管放大X 波段无线电信号的能力比以前提高了五倍。
多晶金刚石有助于降低3D芯片内部的温度。金刚石散热孔会在微米级深的孔洞内生长,这样热量就可以从一个芯片垂直流向堆叠在其上方的另一个芯片上的金刚石散热器。
另外,N 极GaN HEMT上,当金刚石层完全围绕HEMT 时,通道温度显著下降了70 °C。这一突破可能为射频系统带来转型性的解决方案,使其能够以比以往更高的功率运行。
在热骨架概念中,数纳米厚的多晶金刚石层将被整合到晶体管上方的电介质层中以分散热量。这些层次随后通过垂直的热导体连接起来,这些称之为热柱的结构将热量从一个芯片传导到堆叠中的下一个芯片,直到热量到达散热片。经认证后,在一个双芯片堆叠结构中,使用金刚石散热片和热柱架构,温度降低可以到没有热骨架的1/10。模拟显示,在超过五层的AI 加速器中,热骨架的作用至关重要,否则温度将远超典型限制。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂、氮掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。