随着5G通信、人工智能、高性能计算和电动汽车等技术的飞速发展,电子器件的功率密度不断提高,芯片产生的热量呈指数级增长。传统热管理材料已难以满足先进封装技术的散热需求,热管理成为制约电子器件性能提升的关键瓶颈。在这一背景下,金刚石热沉片凭借其卓越的物理特性,正在先进封装热管理领域掀起一场材料革命。

先进封装技术通过将多个芯片以2.5D/3D方式堆叠集成,大幅提高了器件功能密度和互连效率,但也带来了前所未有的热管理挑战。随着芯片特征尺寸不断缩小至纳米级,单位面积功耗急剧增加,热量在微小空间内高度集中。传统封装结构中,热界面材料的热导率通常仅为1-5 W/m·K,而芯片内部热点温度可达150℃以上,严重影响了器件性能和可靠性。因此,开发超高热导率的散热材料已成为先进封装技术发展的迫切需求。
金刚石是自然界已知热导率最高的材料,还具有高热稳定性(空气中可承受600℃以上高温)、低热膨胀系数(约1×10⁻⁶/K)、优异的电绝缘性和化学惰性等特性,使其成为先进封装热管理的理想选择。
热界面材料是连接芯片与散热器之间的关键桥梁,其热导率直接影响整体散热效率。传统聚合物基TIMs的热导率通常低于5 W/m·K。而通过将高纯度金刚石微粉或纳米颗粒填充到聚合物基体中,可显著提高复合材料的热导率。采用表面功能化处理的纳米金刚石颗粒(粒径50-100nm)与高质量石墨烯片协同填充的复合材料,热导率可达30-50 W/m·K,比传统TIMs提高了一个数量级。这种复合TIMs在低填充率(<20 vol%)下即可实现高热导率,同时保持良好的加工性能和机械柔韧性。
对于功率器件和射频器件,金刚石衬底可直接集成在芯片下方,形成高效散热通道。金刚石上生长GaN(GaN-on-Diamond):通过化学气相沉积(CVD)在单晶金刚石上外延生长GaN层,形成直接键合结构,界面热阻极低。实验表明,与传统SiC衬底相比,金刚石衬底可使GaN HEMT器件的沟道温度降低40-60%。
金刚石散热层转移技术:将高质量CVD金刚石薄膜(厚度50-300μm)通过金属化键合工艺转移至芯片背面,作为高效散热扩散层。该技术可与现有半导体工艺兼容,适用于Si、SiC和GaAs等多种半导体材料。
在2.5D/3D先进封装中,金刚石可用于形成垂直热通孔(Through-Diamond Vias, TDVs),有效解决中间芯片散热难题。通过在金刚石层中制备高密度微孔并填充高导热金属(如铜),形成贯穿整个封装体的高效散热通道,将堆叠芯片内部热量直接传导至外部散热装置。
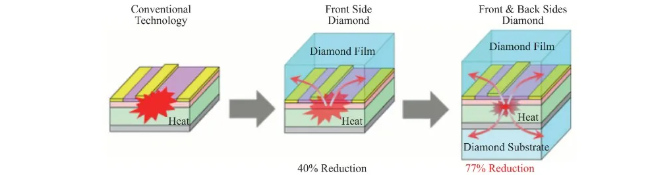
研究数据表明,直径10μm、间距50μm的金刚石热通孔阵列,其等效热导率可达600-800 W/m·K,比传统硅通孔(TSV)提高10倍以上,同时占用面积减少60%。
随着芯片互连密度不断提高,封装基板和中介层的热管理能力也变得至关重要。金刚石凭借其高热导率和低介电常数(ε_r≈5.7),可作为高性能封装基板材料:
金刚石-金属复合材料基板:通过粉末冶金或熔渗工艺制备的金刚石-铜/金刚石-铝复合材料,热导率可达400-800 W/m·K,同时热膨胀系数可调(5-10×10⁻⁶/K),与常见半导体材料匹配良好。
金刚石中介层(Interposer):在2.5D封装中,金刚石中介层不仅提供芯片间的高速互连,还可作为高效散热平台,将多个芯片产生的热量均匀分布并快速导出。
金刚石凭借其卓越的物理特性,正在重新定义先进封装热管理的技术边界。从热界面材料到散热衬底,从热通孔到基板中介层,金刚石为应对日益严峻的芯片散热挑战提供了革命性解决方案。
随着全球半导体产业对高效散热解决方案的需求日益迫切,金刚石这一“终极散热材料”的应用前景广阔,其产业化进程不仅将重塑先进封装技术格局,还可能催生全新的器件架构和应用范式,为整个电子信息产业的发展注入强大动力。
化合积电是一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,核心产品有多晶金刚石(晶圆级金刚石、金刚石热沉片、金刚石窗口片、金刚石基复合衬底)、单晶金刚石(热学级、光学级、电子级、硼掺杂、氮掺杂)和金刚石复合材料等,引领金刚石及新一代材料革新,赋能高端工业化应用,公司产品广泛应用于激光器、GPU/CPU、医疗器械、5G基站、大功率LED、新能源汽车、新能源光伏、航空航天和国防军工等领域。