如今,高端半导体发展封装越来越小、集成越来越密的发展趋势,进而迎来发热极集中、散热路径变短、散热更难等问题。传统的散热材料同样存在导热性有限、物理化学性质不够优异等问题,而金刚石热沉片具备的超高热导率、热膨胀系数的匹配性、电绝缘性能好以及高硬度等优势,为半导体材料封装与散热提供了新的解决方案。
金刚石直接作为封装基板:即在GaN 射频、高功率微波、SiC 功率模块等领域,将GaN、SiC或硅芯片直接倒装焊或共晶焊到金刚石热沉片上。其主要通过将金刚石晶圆经过高精度抛光和使用键合技术使芯片与金刚石基板形成稳定的机械与热连接,此种应用可大幅降低热阻,芯片结温降低以及功率密度提升3倍以上。比如在激光二极管封装应用中,将激光二极管的发光区紧密贴在金刚石热沉片上。由于金刚石面内热导率极高,其能迅速将热点热量均匀化并导出,有效抑制“热透镜效应”,且显著提升激光器的亮度和寿命。
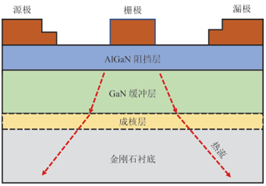
金刚石圆晶键合:即在芯片制造阶段,通过微通道技术或外延生长的方法将金刚石层直接集成到硅晶圆中。主要是利用晶圆键合技术,将金刚石晶圆与硅晶圆直接键合,实现芯片与金刚石的无间隙连接;接着在宽禁带半导体芯片上外延生长金刚石层,形成复合结构。此种方式有利于进一步消除微小的热阻以及提高集成度。
化合积电(厦门)半导体科技有限公司作为一家专注于宽禁带半导体材料研发、生产和销售的国家高新技术企业,致力于为国内外客户提供优质金刚石热沉片材料以及应用方案,为第三代半导体封装发展提供有力支持。